 搜索到2條【Invensas】相關(guān)的全部。
搜索到2條【Invensas】相關(guān)的全部。
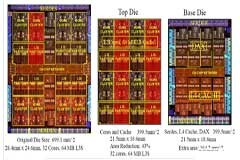
3D芯片堆棧技術(shù)在數(shù)據(jù)中心的應(yīng)用前景
 3D封裝數(shù)據(jù)中心 2021-3-29 11:08
3D封裝數(shù)據(jù)中心 2021-3-29 11:08
加載更多
 查看關(guān)鍵詞的分類頻道
查看關(guān)鍵詞的分類頻道
 搜索到2條【Invensas】相關(guān)的全部。
搜索到2條【Invensas】相關(guān)的全部。
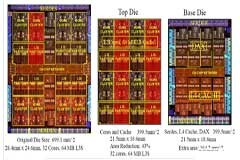
 3D封裝數(shù)據(jù)中心 2021-3-29 11:08
3D封裝數(shù)據(jù)中心 2021-3-29 11:08
 查看關(guān)鍵詞的分類頻道
查看關(guān)鍵詞的分類頻道